底部填充(underfill)
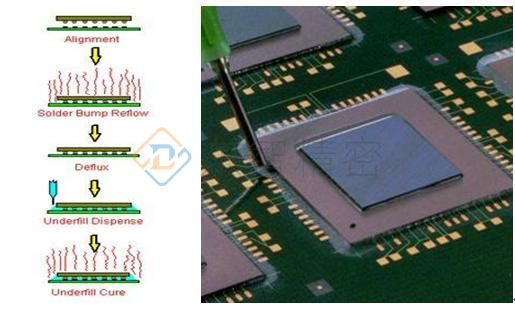
【underfill能保护电子元器件,有效提高抵抗热应力的能力】
随着封装尺寸的减小,3C行业移动电子产品的性能不断得到扩展,底部填充成为电子产品可靠性提高的必要工艺。
对于CSP、BGA、POP等工艺,底部填充能极大提高其抗冲击能力;对FLIP CHIP而言,因其热膨胀系数(CTE)不一致产生热应力极易导致焊球失效,底部填充能有效提高抵抗热应力的能力。
工艺特点
underfill广泛应用于消费类电子行业,比如手机、PAD、notebook等,以及关联的PCB,FPC板。底部填充主要指对BGA、CSP、POP等元器件进行点胶。
在underfill点胶过程中,胶量控制、点胶路径、等待时间和点胶角度规划,是保证底部填充扩散均匀、无散点、无气泡、且实现极窄溢胶宽度的工艺要点。
电子产品的跌落或震动极易引起的芯片或焊点损坏。 而且消费类电子产品厂家对于防尘、防潮、抗跌落、抗震、耐高低温等众多特性的要求越来越高,必然对点胶系统的胶量稳定性、点胶定位精度、溢胶宽度等要求越来越高。
上一篇:没有了